3D-IC 以及传热模型的重要性
judy -- 周一, 03/18/2024 - 10:32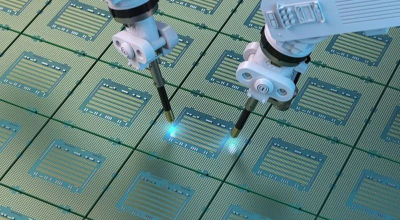
3D-IC 传热模型有助于开发新的封装工艺。本文将讨论 3D-IC 及其传热模型。
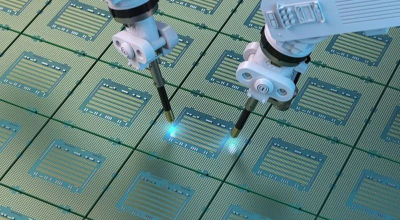
3D-IC 传热模型有助于开发新的封装工艺。本文将讨论 3D-IC 及其传热模型。

Mohamed Naeim 博士曾在CadenceLIVE 欧洲用户大会上做过一场题为《2D/3D 热分析和三裸片堆叠设计实现》的演讲,本文将详细讲述该演讲内容


在本文中,我们不打算重申使用高级封装的优势,而是进行扩展,假设以采用最先进的节点为前提来进行设计
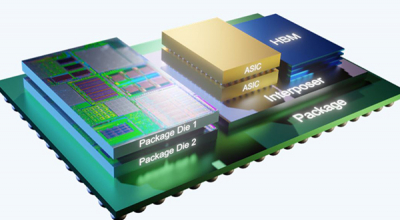
让我们来看看这两种设计工艺之间的区别以及各自的优势和注意事项。
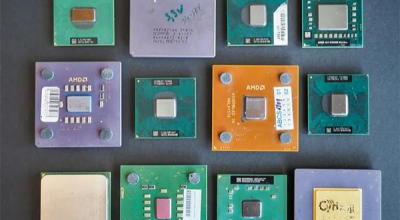
硅通孔是一种主要的互连技术,用于在 2.5D/3D 封装中通过中介层、基板、电源和堆叠的裸片间提供电气连接

从二维设计中分离出存储单元,并自动将其划分为两个工艺层,上层放置存储单元 Macro Cells,下层放置逻辑运算单元 Standard Cells

对于大规模的芯片设计,自上而下是三维集成电路的一种常见设计流程。在三维布局中,可以将原始二维布局中相距较远的模块放到上下两层芯片中