MEMS是Micro Electro Mechanical Systems(微机电系统)的缩写,具有微小的立体结构(三维结构),是处理各种输入、输出信号的系统的统称。
是利用微细加工技术,将机械零零件、电子电路、传感器、执行机构集成在一块电路板上的高附加值元件。
MEMS工艺
MEMS工艺以成膜工序、光刻工序、蚀刻工序等常规半导体工艺流程为基础。
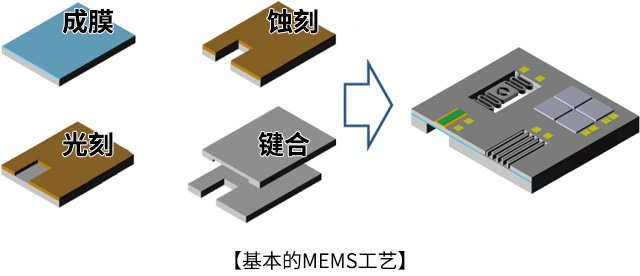
下面介绍MEMS工艺的部分关键技术。
晶圆
SOI晶圆
SOI是Silicon On Insulator的缩写,是指在氧化膜上形成了单晶硅层的硅晶圆。已广泛应用于功率元件和MEMS等,在MEMS中可以使用氧化膜层作为硅蚀刻的阻挡层,因此能够形成复杂的三维立体结构。
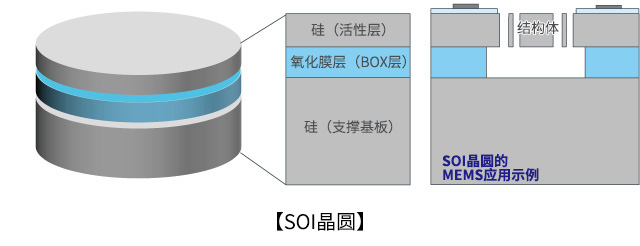
TAIKO磨削 “TAIKO”是DISCO株式会社的商标
TAIKO磨削是DISCO公司开发的技术,在磨削晶圆时保留最外围的边缘,只对其内侧进行磨削。
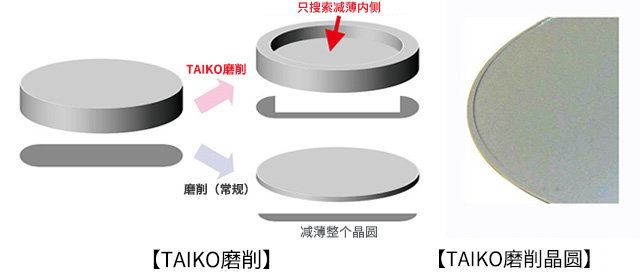
TAIKO磨削与通常的磨削相比,具有“晶圆曲翘减少”、“晶圆强度更高”、“处理容易”、“与其他工艺的整合性更高”等优点。
晶圆粘合/热剥离片工艺
通过使用支撑晶圆和热剥离片,可以轻松对薄化晶圆进行处理等。

晶圆键合
晶圆键合大致分为“直接键合”、“通过中间层键合”2类。
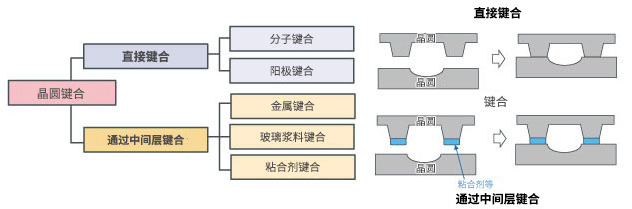
直接键合不使用粘合剂等,是利用热处理产生的分子间力使晶圆相互粘合的键合,用于制作SOI晶圆等。
通过中间层键合是借助粘合剂等使晶圆互相粘合的键合方法。
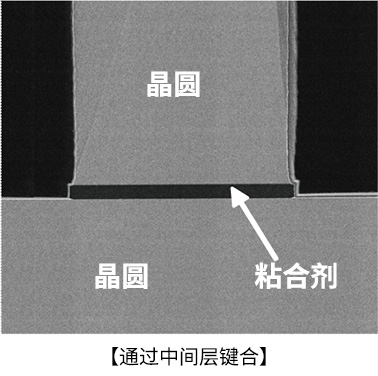
蚀刻
各向同性蚀刻与各向异性蚀刻
通过在低真空中放电使等离子体产生离子等粒子,利用该粒子进行蚀刻的技术称为反应离子蚀刻。
等离子体中混合存在着携带电荷的离子和中性的自由基,具有利用自由基的各向同性蚀刻、利用离子的各向异性蚀刻两种蚀刻作用。
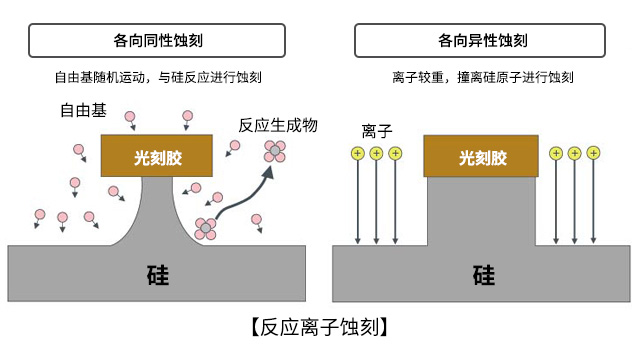
硅深度蚀刻
集各向异性蚀刻和各向同性蚀刻的优点于一身的博世工艺技术已经成为了硅深度蚀刻的主流技术。
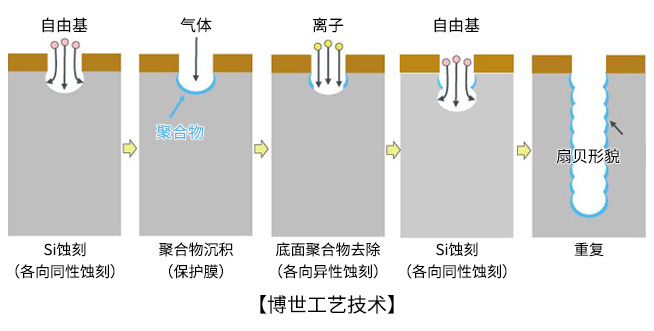
通过重复进行Si蚀刻⇒聚合物沉积⇒底面聚合物去除,可以进行纵向的深度蚀刻。
侧壁的凹凸因形似扇贝,称为“扇贝形貌”。
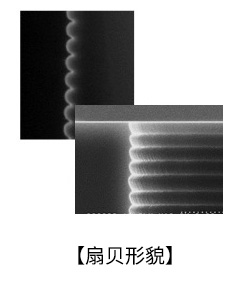
成膜
ALD(原子层沉积)
ALD是Atomic Layer Deposition(原子层沉积)的缩写,是通过重复进行材料供应(前体)和排气,利用与基板之间的表面反应,分步逐层沉积原子的成膜方式。
通过采用这种方式,只要有成膜材料可以通过的缝隙,就能以纳米等级的膜厚控制,在小孔侧壁和深孔底部等部位成膜,在深度蚀刻时的聚合物沉积等MEMS加工中形成均匀的成膜。
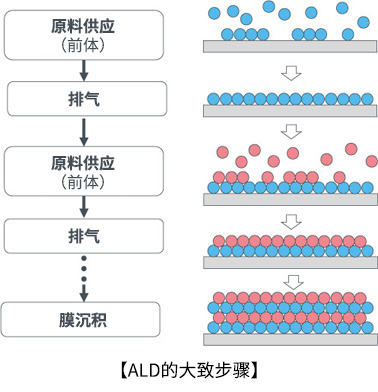
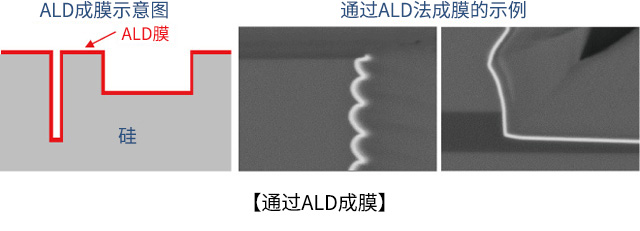
文章来源:罗姆官网
