作者:泛林集团公司副总裁兼电介质原子层沉积产品总经理 Aaron Fellis
随着电子设备精密化,人们愈发要求半导体技术能以更低的成本实现更优的性能和更大的容量。这些趋势推动了半导体技术的重大进步,在过去十年中2D NAND逐渐过渡到3D NAND。
逻辑领域的3D过渡也已经开始,FinFET(鳍式场效应晶体管)技术让位于全包围栅极 (GAA) 晶体管和互补场效应晶体管 (CFET) 架构展示出极大优势。许多人期待着动态随机存储器 (DRAM) 也能在未来跟进。然而,在3D时代,半导体微缩非常困难:芯片制造商需应对每一个新节点上不断提升的复杂性,同时面临兼顾提升晶体管密度和降低功耗的挑战。

制造方法和技术的持续进步对于实现并进一步推动下一代GAA晶体管、DRAM架构和3D NAND器件(目前已包含200多层)的微缩至关重要。为了制造具有纳米级精度和成本结构合适的芯片,像泛林集团这样的晶圆制造设备商需要推动等离子体物理学、材料工程和数据科学的发展边界,以提供所需的设备解决方案。利用数据的力量是将这些技术投入生产的突破点。我们正在从我们的设备中收集更丰富的数据,并使用更先进的数据科学技术将其转化为可在数百万个晶圆上重复的工艺。
半导体行业在应对3D时代的挑战时,有五个值得关注的潜在趋势。
1.多功能工艺腔室将刻蚀和沉积更紧密地结合在一起以实现大批量生产
随着薄膜变得更加复杂和精细,以及纵向和横向填充和去除的要求增加,芯片制造工艺必须不断发展,以经济可行的方式满足一系列要求。在单个工艺腔室中实现多种功能可能是一个有效途径,它需要整合不同的沉积或刻蚀技术来处理3D结构的需求,甚至需要同时整合沉积和刻蚀技术,以更好地覆盖3D外形和原位修复工艺。在最具挑战性的大批量生产中,这个方法或许可以加速可靠薄膜的创建。
2. 更先进的逻辑芯片需要更先进的互连金属
钨和氧化钨已经开始在一些逻辑互连中取代大马士革铜。随着3D时代的微缩持续,晶圆制造技术正在扩展常用金属的边界,以降低电阻和功耗,并减少信号损失。为了后端的应用,人们也在不断探索钼等替代金属。
3. 小芯片集成将推进微缩以延续摩尔定律
随着硅的微缩成本越来越高,在技术节点间保持和以前一样的开发时间也变得更具有挑战性。芯片制造商正在采用基于小芯片的解决方案,以实现硅以外的微缩。封装在推进系统级封装集成和延续摩尔定律方面起着重要作用。

硅通孔刻蚀和电镀解决方案在先进封装解决方案的高深宽比集成中至关重要。为了满足下一级互连的要求,也需要新的基于基板的方法。泛林集团通过对SEMSYSCO的收购,扩大了集团封装产品的组合,为小芯片间或小芯片和基板间的异构集成带来了创新的清洁和电镀技术。
4. 数据洞察将提高运营效率
基于人工智能的预测性建模技术正在加快产品的研发,并使芯片制造商能够更快地进入制造阶段,同时为设备和工艺开发商带来新的洞察和更高的效率。数据也日渐成为制造工艺中的关键资源。腔室内的传感器可以监测设备的一致性并帮助快速检测问题。例如,泛林集团开创性的自感知Sense.i®平台能将数据智能与先进的等离子体刻蚀技术结合在一个紧凑的高密度架构中,以提供高生产率的工艺性能。
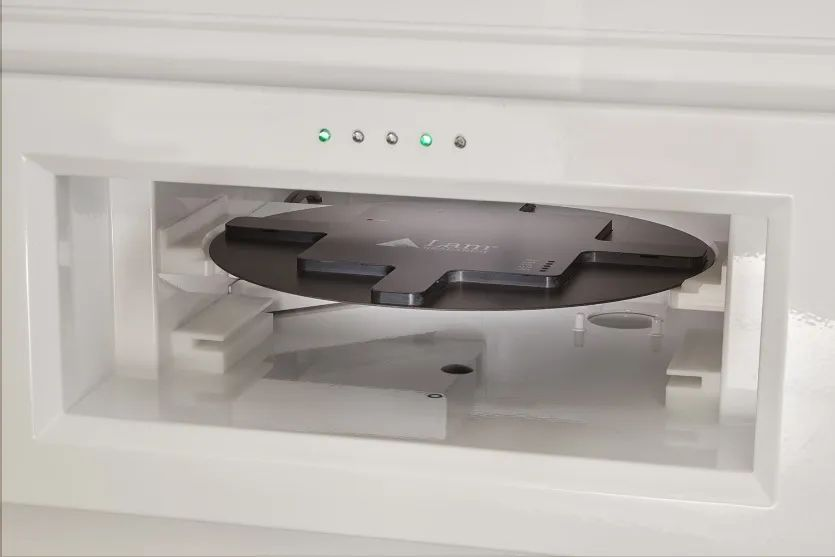
在泛林集团Equipment Intelligence®(设备智能)技术的支持下,Sense.i平台能提供继续推进均匀性和刻蚀轮廓控制所需的关键刻蚀技术,以实现良率最优化并降低晶圆成本。Sense.i使半导体制造商能够捕捉并分析数据,包括图形识别,并指定改进措施。Sense.i还具有自主校准和维护功能,可减少停机和劳动力成本,同时提供机器学习算法,使设备能够自适应、以最大限度减少工艺变化并提高晶圆产量。
5. 可持续的创新将带来用料更少的高性能芯片
正如泛林集团在2021年所提出的目标:到2030年100%使用可再生能源,到2050年实现零碳排放,以及2022年SEMI全球半导体气候联盟的成立所表明的那样,人们越来越关注可持续发展。许多芯片制造商正在寻找制造设备和技术,在提供合适的性能和成本结构的同时,支持其实现降低功耗和减少用料的长期目标。
结论
精密的电子设备需要日益先进的半导体技术,其不断增长正挑战着晶圆制造设备商和芯片制造商在3D时代不断创新现有的方法和材料。持续的合作、创新和新的突破需要采用新的方法并利用丰富的数据,将会是推动进步和可持续制造以实现前沿技术的关键。
本文转载自: 泛林集团微信公众号
