本文要点
要想准确预测集成电路封装的结温和热阻,进而优化散热性能,仿真的作用举足轻重。
准确的材料属性、全面的边界条件设置、真实的气流建模、时域分析以及实证数据验证是成功进行集成电路封装热仿真的关键。
要实现高效传热,必须了解并管理集成电路封装的热阻 ΘJA、ΘJC 和 ΘJB。
要想确保集成电路的可靠性,有必要了解封装的热特性。要将器件结温保持在允许的最大限值以下,集成电路必须能够通过封装有效散热。集成电路封装热仿真有助于预测结温和封装热阻,从而帮助优化热性能以满足特定要求。
集成电路封装热仿真要点
准确的材料属性
确保仿真中使用的材料热特性准确无误,并随温度变化而变化。
全面的边界条件设置
设置的边界条件要尽量接近真实世界场景,以获得更准确的仿真结果。
纳入实际气流模式
在风冷系统中,要对实际气流模式进行建模,而不是假设理想条件。
动态系统的时域分析
进行时域热分析,了解随时间变化的热响应,尤其是在动态系统中。
实证数据验证
尽可能利用物理原型的实证数据来验证仿真结果。
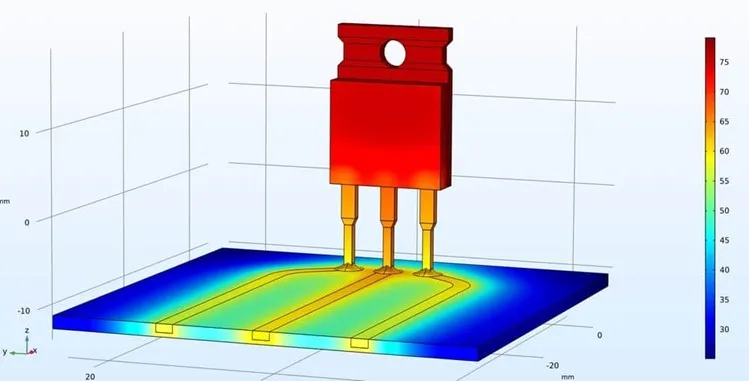
集成电路封装晶体管热仿真
集成电路封装热仿真流程的步骤(示例)
创建三维模型
包括裸片、基板、键合线、封装材料和封装主体,以及任何外部引脚、金属片或其他必要的散热器。
确定仿真的材料参数和边界条件
热仿真中的关键材料参数包括比热和热传导率。这些属性与温度有关,需要仔细定义以确保准确性。
边界条件至关重要,因为它们决定了模型边缘的温度和热量传递。这些边界可以是热沉边界,用于散热,也可以是热绝热边界。在模型周围都是空气的情况下,空气的存在和流动成为严重影响整个模型温度分布的重要因素。
确定并分析随时间变化的温度分布
除了确定最终温度或静止温度外,分析温度分布随时间变化的情况也能为热仿真提供更多启示。例如,在对封装器件进行基于时间的仿真时,可以观察 100 毫秒内的温度分布。这种基于时间的仿真提供了两个视角:
热量主要来自热源,在最初的 100 毫秒内,根据封装的热阻,发热可能是一种局部现象,也可能蔓延到电路板的其他部分。
通过分析可了解热量传播方向的趋势,以及不同器件和材料在此过程中的作用。例如,键合线可能会造成很大的影响,而作为绝缘体的模塑可能不会显著改变初始时间内的温度分布。
这种基于时间的详细仿真对于了解器件内的热动力学至关重要。
仿真时应重点关注的器件
1.裸片
大多数集成电路封装中的热源是裸片,裸片的材料属性和发热特性是仿真的核心
2.键合线
键合线经常被忽视,但它对封装内的热分布有重大影响
3.封装模塑
封装模塑起到绝缘体的作用,材料的热特性和厚度对散热有重要影响
4.引线和焊点
引线和焊点是热量传递到 PCB 的次要途径,会影响整体热性能
热阻
半导体中的热量管理几乎与热阻(通常以“θ”表示)直接相关,热阻是描述材料传热特性的关键指标。集成电路 (IC) 封装的热阻用于量化将 IC 产生的热量传递到电路板或周围环境的能力。给定两个不同点的温度后,只需根据热阻值就能精确确定这两个点之间的热流量。
集成电路封装热阻变量分析——

为了满足各种集成电路封装热仿真需求,Cadence Celsius Thermal Solver 为集成电路封装热仿真提供了全面的解决方案。它采用经过生产验证的大规模并行架构,可在不影响准确度的情况下提供比传统解决方案更快的性能。
文章来源:Cadence楷登PCB及封装资源中心
